晶片行业
-
概述定义:晶圆切片是半导体芯片制造中必不可少的工序,是半导体芯片制造中的后一个工序。晶圆切片是将完整的晶圆片分割成几个单一的颗粒。目前,我们已经具备了GPP(玻璃钝化工艺)生产的骰台二极管、金刚石晶闸管晶片和触发管晶片的技术能力。与传统的切丁工艺相比,该工艺具有诸多优势,国内已有多家工厂采用该工艺生产GPP晶圆及成品。新万博新版
存在的问题:
●刀片直接作用于硅片表面,同时容易造成损伤;
●刀片较厚,刀具线宽较大;
●增加供应。刀片每半年更换一次;
●由于笨重的硅烟造成严重的环境污染。
为了满足对高质量产品的需求,很多工厂都在不断寻求新技术来提高工作效率,从而为客户提供更高质量的产品。新万博新版 -
我们的解决方案
晶圆切片行业主要有两种切割技术。一种是传统的刀片切割,另一种是现代的激光切割。我将通过比较来证明激光切骰子的优点。
首先采用切片法对晶圆进行切片。这种方法在芯片切割市场上仍然很流行,特别是非集成电路芯片切割。金刚石锯片切割是一种常用的切割方法。刀片切削
当工件硬而脆时,金刚石会将其断裂、破碎,然后用刀片将粉末去除。原则
激光切割
由于聚焦的优点,焦点可以小到亚微米。可承接小零件的加工,特别是硅片的微加工。即使在没有高脉冲能量的情况下,也可以获得更高的能量密度来有效地加工材料。
●激光切块可避免无接触断屑等损伤现象;
●光纤激光器光束质量高,对芯片电性能影响小;
●激光切割速度可达150mm/s;
●激光具有更好的通用性和兼容性,可以在各种厚度的晶圆上工作;
●激光可以切割复杂的晶圆,如六角槽芯;
●激光切割可在无去离子水的情况下连续24小时工作,不会造成刀具磨损。切割设备 传统切割(砂轮) 激光切割(光学) 切割速度 5-8mm /秒 1 - 150 - mm / s 切割线宽 30 ~ 40μ 30 ~ 45亩 切割效果 容易破碎和倒塌 光滑、平坦、坚固 热影响区 更大的 小 残余应力 更大的 小 晶片厚度要求 超过100 um 几乎没有要求 适应性 更换不同晶片的切割机 适应不同晶片芯片 损失 需要去离子水
需要更换刀片
损失是巨大的损失很小 -
客户的利益有了激光技术,客户将受益匪浅:
●避免在无任何接触的情况下出现断屑等损坏现象;
●优质激光束提高产品成品率;
●速度快,可达150mm/s;
●更好的通用性和兼容性,可以工作在各种厚度;
●可以切割复杂的晶圆片;
●无刀具磨损,可进行24小时连续工作。
-
相关应用程序
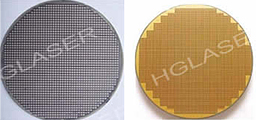
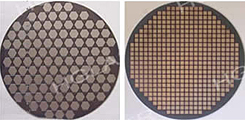
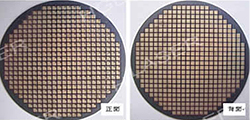
二极管GPP晶圆触发管GPP晶圆六边形GPP晶圆放电管晶圆双表金刚石晶圆
-
推荐模型